課題の解決事例 Solution case
半導体のジャンクション温度の推定
- ジャンクション温度
- 熱流体解析
- 熱連成解析
Issue
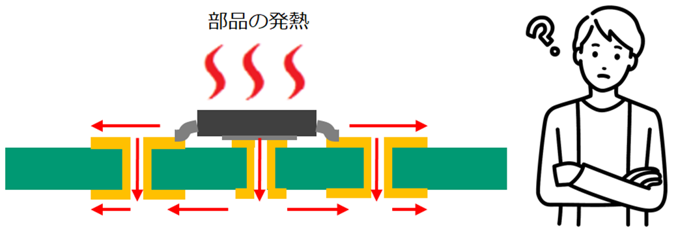
近年、発熱の大きい面実装部品では、パッケージ裏面にサーマルパッドを設けているものが多くなりました。これらの部品では熱を基板に逃がすことを前提としており、基板の放熱能力次第で、部品の温度上昇が大きく変わってしまい、温度上昇の程度を予測するのが難しくなっています。
Solution
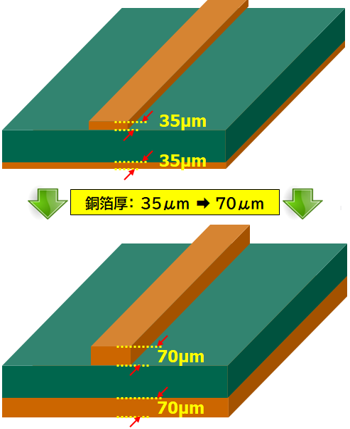
スペースに余裕がある場合は、FETなどの面実装部品にフィンをつけて発熱対策を行う場合もありますが、スペースに余裕のない基板の場合は、サーマルビアを設けたり放熱用の銅箔面積を大きく取り、熱伝導率の高い銅箔を利用して基板全体に熱を分散する設計を行います。また、厚銅基板を使用することで、基板全体に、より熱を分散させることが可能です。車載機器など大電流をパターンに流す場合などにも、厚銅基板を使用することでパターンの温度上昇も抑えることができるようになります。
関連する基板解析シミュレーション
熱連成解析
当事例では、基板の種類や負荷電流などをパラメータにして、ICの端子温度や基板の温度分布がどの程度変化するのかを推定するのに、熱連成解析を活用しました。 厚銅基板を使用することで、ICの端子温度が約20℃下がり、部品のジャンクション温度の定格内に収まることを確認できました。